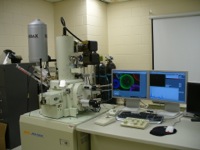
Field-emission Scanning Electron Microscope
JEOL JSM 7401F Unit 1 (2025)
Sample Characterization Equipment. Location: Olney OG-1. Training Estimates: 6 Hours and must have demonstrated proficiency in using JEOL 6390 SEM. Cold-cathode tip field emission gun; 1.0 nm resolution at 15 kV accelerating voltage; 0.1 – 30 kV accelerating voltage range; 25x – 1,000,000x magnification range. Multiple detectors including Everhart-Thornley secondary electron detector, semi-in-lens secondary electron detector with r-filter, and pneumatically retractable solid state back-scattered electron detector. Large specimen exchange port accommodating 4 inch diameter and 40 mm height samples. EDAX Genesis XM2 Imaging System with 10 mm2 Si(Li) detector for EDS analysis. Nanometer Patterning Generation System for e-beam lithography.
Capabilities
- ✓Field emission SEM
- ✓1.0 nm resolution
- ✓High magnification imaging
- ✓Multiple detector systems
- ✓EDS elemental analysis
- ✓E-beam lithography
- ✓Large sample accommodation
- ✓Advanced imaging modes
Specifications
| manufacturer | JEOL |
| model | JSM 7401F Unit 1 |
| resolution | 1.0 nm at 15 kV |
| magnification | 25x – 1,000,000x |
| voltage range | 0.1 – 30 kV |
| sample size | 4 inch diameter, 40 mm height |
| eds detector | EDAX Genesis XM2, 10 mm2 Si(Li) |
| training requirement | 6 hours + JEOL 6390 proficiency |
Similar Instruments
